2025/03/21
830
SiC MOSFET与肖特基势垒二极管的完美结合,提升电力转换性能 - 国际电力元件展
2025PCIM Asia Shanghai — 上海国际电力元件、可再生能源管理展览会暨研讨会将行于9月24日至9月26日在上海新国际博览中心举行,邀您关注今日上海电子展新资讯:
使用反向并联的肖特基势垒二极管(SBD)可以提高碳化硅MOSFET在电力转换应用中的性能和可靠性。本文将展示两家SiC器件制造商在集成SBD与MOSFET为单芯片解决方案方面所取得的进展。
SiC肖特基二极管
SiC肖特基二极管相较于标准的硅p/n二极管提供了许多优势。一个关键优势是缺乏反向恢复损失,这种损失在p/n二极管中尤为显著,特别是在高温、快速切换和高电流应用中。除了增加的切换损失之外,反向恢复还会因为结中存在多余的少数载流子而导致电压过冲,这对杂散电感和电磁干扰(EMI)滤波造成限制。

这些二极管的结构基本上是一个轻掺杂的n–层位于一个重掺杂的n+层之上。施加在n–层上的阳极金属接触用于形成肖特基结,典型的开启正向电压降约为1伏。商业上可获得的SiC肖特基二极管的电压等级高达3.3千伏,可以成为高压电力转换应用中硅IGBT充电二极管的首选。
SiC MOSFET的体二极管在典型情况下开启电压超过2.5伏,多个制造商的数据表列出了在额定的第三象限电流下正向电压降接近4伏。这种高电压降直接导致在自由轮回操作期间的导通损失增加。此外,虽然SiC MOSFET的体二极管得益于较小的载流子寿命,因而相较于硅p/n二极管具有更低的反向恢复电荷,但这些反向恢复损失在高温快速切换操作下可能占总切换损失的显著部分。
存在于SiC基片和外延层中的基面缺陷可能导致体二极管导通时出现堆垛缺陷。这可能随着时间的推移降低二极管的性能,最终导致器件失效。这一潜在的可靠性失效机制在厚外延层的高压器件中可能会被放大。
SiC MOSFET的体二极管开启时具有负温度系数,即在高温下导通更强。这可能对第三象限导通下的并行操作产生限制,因为热失控的风险更高。
使用反向并联的SiC肖特基二极管克服了上述SiC MOSFET体二极管的限制。其使用的好处通常体现在导通和切换损失的减少。由于SBD的低开启电压,死区时间控制也可以更优化、更容易地完成,而开启导通的正温度系数使其更容易并联。切换损失的改善伴随着警告,在某些条件下,SBD的附加非线性电容实际上可能增加切换损失,尤其是在轻负载条件下。
在使用SiC MOSFET的转换器中,反向并联SBD的一个主要限制是这些器件的突发电流能力较低。这是由于这些单极器件的差动导通电阻显著较高。相比之下,体二极管中的导电调制导致在高电流下的差动电阻较低。这种效应在高温下可能被放大。虽然使用与SBD结合的p/n结(例如在合并的PiN肖特基二极管中)可以缓解这个问题,但额外的芯片、封装和组装成本则是另一个缺点。
接下来,我们将讨论两家SiC制造商提出的集成MOSFET/SBD器件的解决方案,以应对上述限制。
集成MOSFET/SBD
东京电子(Toshiba)最近宣布正在进行带有嵌入式SBD的1200V SiC MOSFET的芯片采样。新的X5M007E120器件针对的是电动汽车牵引逆变器应用。该器件在25°C时的典型导通电阻为7.2毫欧。在175°C、50A电流下,由于SBD的存在,第三象限电压降仅为1.40V。可用于容纳SBD的宝贵MOSFET通道面积可能会降低器件的特定导通电阻指标(RDS(on) × 芯片面积)。通过将SBD以交错模式排列,该指标改善了20%至30%。该模式如图1所示。
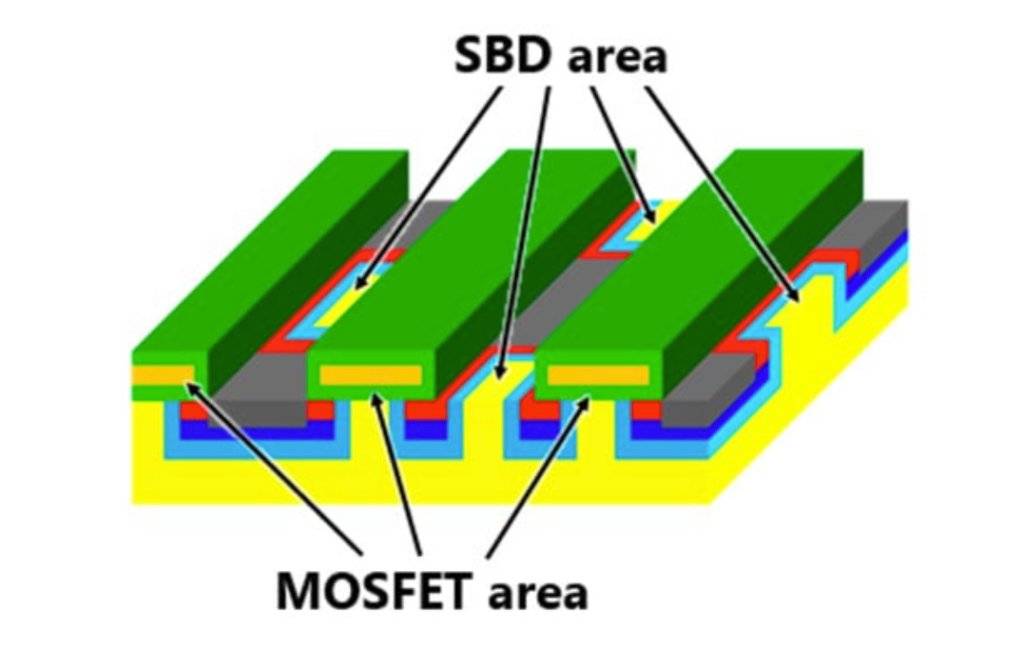 图1
图1
这种交错模式的通道密度提高允许在MOSFET内部嵌入的SBD中达到约两倍于条纹版本的单极反向电流密度。如图2所示,所实现的特定电阻为0.27Ω-mm²,甚至在标准的1200V(即非嵌入SBD的)平面SiC MOSFET中也是一个具有竞争力的数字。
 图2
图2
短路耐受能力是驱动电动机的电力电子的关键指标。硅IGBT具有非常强的短路耐受时间(SCWT),在10微秒范围内。SiC MOSFET在过去几年已经在SCWT方面取得了许多改进。东京电子采用了深p井结构来改善这一指标。SCWT与器件的特定导通电阻成反比,低阻抗结构可能需要快速感应以在活跃功率器件的短SCWT时间之前触发栅极驱动器。如图3所示,使用深p井屏障改善了这一权衡。
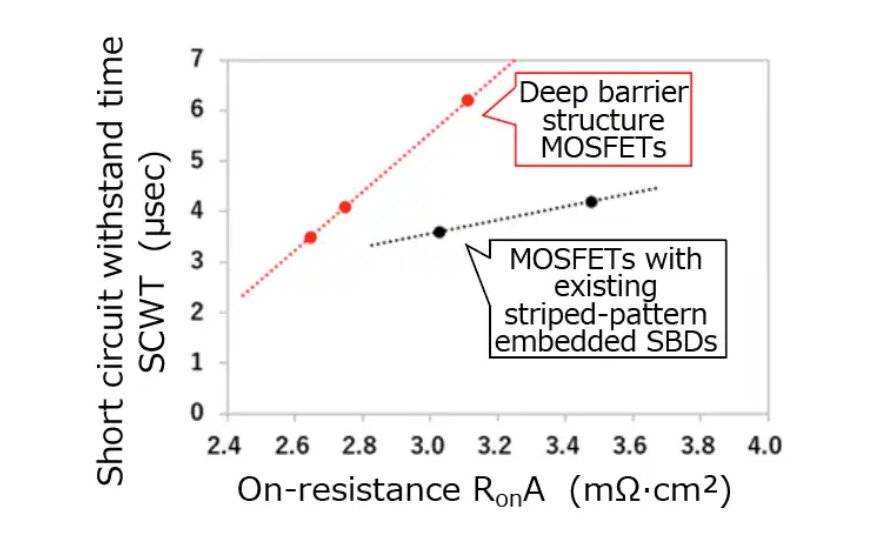 图3
图3
现在让我们来看一下在嵌入式SiC SBD-MOSFET器件中的突发行为的改善。2023年,三菱电机公司宣布了一款3.3 kV/800 A的SiC半桥功率模块FMF800DC-66 BEW。今年还推出了400 A和200 A版本。Unifull系列产品包括嵌入式SBD器件,以提高性能。这些模块针对大型工业设备、铁路牵引系统、电力生产和分配基础设施等。对这些模块的一个关键改进是即使在存在SBD结构的情况下也能处理突发电流。
在一个含有SBD的并联芯片连接模块中,制造过程中的轻微尺寸变化可能导致突发电流集中在特定芯片上。这些小变化在制造过程中是不可避免的。例如,如果围绕SBD n–阳极层的p层宽度在一个芯片上稍大于其他芯片,可能导致p/n体二极管的突发电流优先发生在该芯片上。这可能造成热失控并损坏该特定芯片,从而影响整个模块。三菱实施的一个解决方案是从每个芯片内的单元格中移除SBD。这个单元格可以占据总芯片的非常小的百分比——例如1%。因此,对整体第三象限SBD导通的影响并不大。每个芯片上的这个特定单元格允许优先的突发起始电流在所有芯片的位置同时发生。由于突发的开始减少了周围SiC单元格的电阻(载流子扩散降低了漂移电阻,而更高的温度导致p/n二极管导通的负温度系数),它也触发了这些相邻单元格的突发,形成了连锁反应。
新的芯片结构使突发能力比标准SiC嵌入结构提高了5倍,达到了传统硅功率模块所获得的水平。
文章来源:浮思特科技
2025PCIM Asia Shanghai — 上海国际电力元件、可再生能源管理展览会暨研讨会将于2025年9月24日至9月26日在上海新国际博览中心举行;上海电子展更多资讯,详情请登陆官网 https://pcim.gymf.com.cn
扫码实名预约,领取入场证!

| 凡本网注明“来源:广州光亚法兰克福展览有限公司”的所有作品,版权均属于广州光亚法兰克福展览有限公司,转载请注明。 凡注明为其它来源的信息,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点及对其真实性负责。若作者对转载有任何异议,请联络本网站,联系方式:020-38217916;我们将及时予以更正。 |


欢迎莅临:PCIM Asia Shenzhen — 深圳国际电力元件、可再生能源管理展览会暨研讨会!
电力电子、智能运动、可再生能源、能源管理
主办单位官方微信









