2026/03/16
330
300mm碳化硅技术:下一代AI和HPC先进封装材料基础_碳化硅技术展pcimasia
在今年初,美国碳化硅(SiC)芯片制造商Wolfspeed宣布已成功生产单晶300mm碳化硅晶圆,这标志着碳化硅技术的演进取得了重大突破,并为新兴应用提供了关键支持。Wolfspeed称,正在引领向300mm技术的转型,为未来的商业化量产铺平了道路。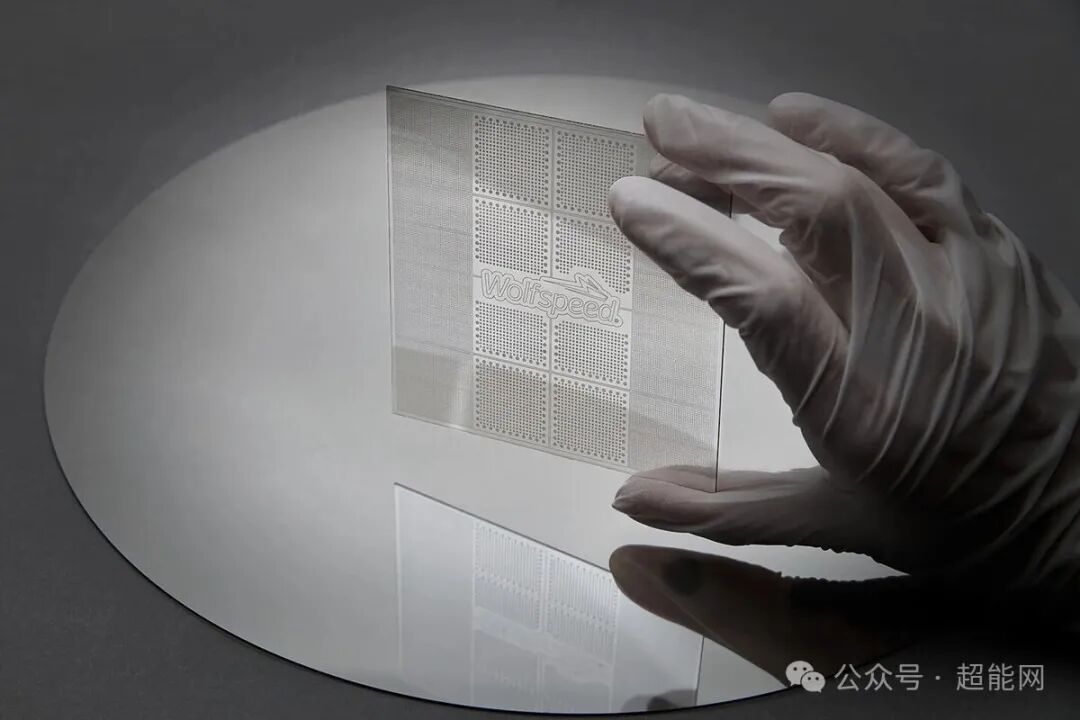
Wolfspeed近日介绍了其300mm碳化硅技术,有望在未来数年内,为先进人工智能(AI)和高性能计算(HPC)异构封装提供可扩展的材料基础,从而实现与行业制造基础设施相匹配的热管理、机械完整性和电气集成水平。
单晶碳化硅独特地融合了其他可扩展半导体基板所不具备的材料特性:
热性能-热导率为370–490 W/m·K,可达普通硅材料的三倍,实现卓越的横向与纵向热扩散效果。
机械强度-高刚性、高强度和高热稳定性,可支撑大面积多芯片组合及HBM堆叠结构。
电气性能-高电阻率和介电强度能够提高了布线密度,降低了信号传输损耗,并简化供电与隔离结构的集成。
同时向300mm晶圆过渡,使得先进封装材料与尖端半导体制造及晶圆级封装工艺实现协同,能充分利用现有行业工具集和基础设施。既保障了可重复的大规模量产能力,又支持成本缩放与生态系统兼容性。
300mm碳化硅技术的重大意义
300mm碳化硅技术的突破,标志着第三代半导体迈入规模化制造新阶段,其重大意义主要体现在实现“降本增效”的规模化拐点、解锁AI与高性能计算(HPC)的散热瓶颈、推动产业链标准化与生态融合三点。
1、实现“降本增效”的规模化拐点:
相比主流的6英寸晶圆,300mm晶圆面积增大约2.25倍,单片晶圆可产出的芯片数量大幅提升。这不仅直接降低了单位芯片成本(预计降幅可达30%-50%),还显著提升了厂房产能密度,为碳化硅在新能源汽车、光伏等领域的普及扫除了成本障碍。
2、解锁AI与高性能计算(HPC)的散热瓶颈:
碳化硅具备极高的热导率(约为硅的3倍)和机械强度。300mm技术使其能够作为先进封装中的“中介层”或散热基板,解决AI芯片因高功率密度带来的散热难题,支撑下一代异构封装架构的发展。
3、推动产业链标准化与生态融合:
300mm尺寸与现有成熟的硅基半导体制造基础设施(如设备、工艺)对齐,降低了产业链的适配难度,加速了碳化硅从“特种材料”向“主流制造”的转变,为构建统一的半导体制造生态奠定了基础。
*图源网络,仅为丰富文章内容,若作者对转载有任何异议,欢迎致电等联系删除
来源:广州光亚法兰克福展览有限公司
2026 PCIM Asia Shenzhen 深圳国际电力元件、可再生能源管理展览会暨研讨会将于2026年8月26-28日在深圳国际会展中心 (宝安)举行。
深圳电力元件展门票领取及更多资讯,详情请点击:2026 PCIM Asia Shenzhen 深圳国际电力元件、可再生能源管理展览会暨研讨会
| 凡本网注明“来源:广州光亚法兰克福展览有限公司”的所有作品,版权均属于广州光亚法兰克福展览有限公司,转载请注明。 凡注明为其它来源的信息,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点及对其真实性负责。若作者对转载有任何异议,请联络本网站,联系方式:020-38217916;我们将及时予以更正。 |


欢迎莅临:PCIM Asia Shenzhen — 深圳国际电力元件、可再生能源管理展览会暨研讨会!
电力电子、智能运动、可再生能源、能源管理
主办单位官方微信









